多孔質ポリイミドを用いた柔軟性のある断熱材
高い空孔率による低誘電率ポリイミドシートへの応用
背景・課題とKRIの技術による解決方法等
なぜポリイミドなのか?
- 樹脂多孔質体は、家電・輸送機器の断熱材、分離膜、電池用セパレーターなど産業部材として利用されていますが、耐熱性が低く、圧縮塑性変形を起こすなど素材としての耐久性に乏しいものが多く、適用可能な応用領域が限定されていました。
- これへの解決策として、耐熱性樹脂であるポリイミドを多孔質材料にするアプローチが有り、その多孔化する技術として超臨界流体乾燥法がありますが、工業的により簡便な方法の開発が求められています。
- KRIでは、凍結乾燥法および常圧乾燥法によるポリイミドの多孔化と各種応用技術の開発を進めています。 また、多孔化したポリイミドの炭化によるカーボンエアロゲルの創出と電池関連材料への展開を目指しています。

本技術の特徴
ナノサイズの空孔形成が可能に−高断熱性能、低誘電率を実現
- 凍結乾燥法および常圧乾燥法によって200nm以下のナノサイズの空孔を有する多孔質ポリイミドの作製が可能になりました。 超臨界流体乾燥のような高耐圧設備の必要が無く、食品加工などでも使用されるフリーズドライ製法、あるいは常圧で自然乾燥する方法を適用できます。 また、多孔質化のためのポロジェン(孔の原型となり、後の工程で除去される物質)を使用しませんので、これの除去工程が必要ありません。
- この多孔質ポリイミドは70%以上の気孔率が有り、高い断熱性能と低誘電率を実現しています。
- 熱伝導率は 30mW/m・K 以下であり、一般的なガラスウールや樹脂フォームと同等の断熱性能が有ります。 したがって、一般的な樹脂フォームでは耐熱性の点で難しい場面での利用が考えられます。
- フレキシブルプリント回路基板で実績のあるポリイミドフィルム(緻密膜)の場合、比誘電率は0.3程度ですが、多孔化によって半分以下の誘電率になります。
- 現状では1GHzでの誘電正接は緻密膜よりも大きく、この低減が今後の課題ですが、材料構造の見直しによってクリアすることを目指しています。
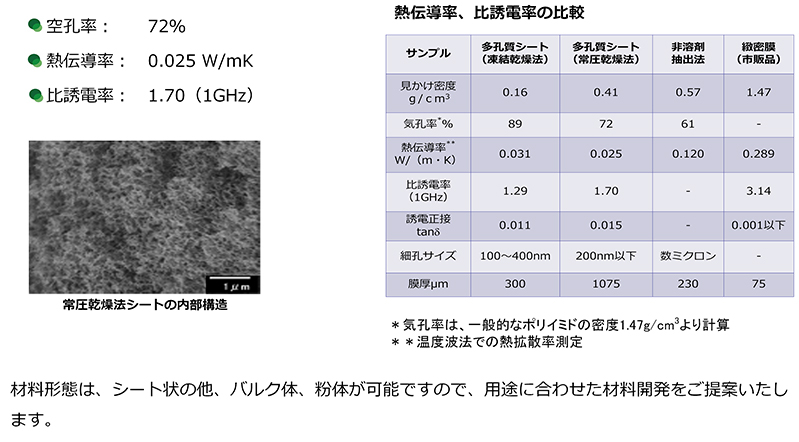
KRIからのご提案
低誘電率材料、セパレーター、フィルター用途への展開
- ●高い空孔率による低誘電率ポリイミドシートを用いた高周波数対応フレキシブル回路基板の開発
高周波数のGHz帯の利用が今後ますます加速していくことが予想されます。
通常では、周波数が上がるとともに伝送損失(伝送によるエネルギーの損失)は増加していくため、この損失を低減させることがフレキシブル回路基板においても求められます。 - ●ナノスケールの連続貫通孔を利用した二次電池用セパレーター、濾材、分離膜の開発
多孔質体の孔径をコントロールする方法、内表面を化学修飾する方法によって、例えばセパレーターにおける目的物資の透過性や、濾材・分離膜における分離性能など材料の特性を制御できる可能性があります。 - ●汎用樹脂を用いた多孔質材料開発
凍結乾燥法や常圧乾燥法は、汎用の各種ポリマーにも適用することが可能です。
ご要望の樹脂材料をベースポリマーに用いた多孔質シートの作製、それらの応用技術の開発についてもご提案差し上げます。
